4.4 电迁移效应
电迁移是集成电路设计中一个十分关键的问题,特别是在技术节点较低的情况下,由于金属互连的横截面积变得非常小,电迁移效应(electro-migration effect)变得愈发显著。简单来说,电迁移效应指的是在金属导线中,当电子受到大电流作用时,会导致电子迁移的现象。
电迁移机制:
当高电流密度通过金属互连时,电流载体电子的动量可能通过碰撞转移给金属离子,使得离子沿着电子流的方向移动,这一现象被称为电迁移效应。电流密度 J 被定义为单位横截面积上的电流,即
其中:I为电流,A为互连横截面积。
随着技术节点的缩小,金属互连的横截面积减小,电流密度在较低技术节点中显著增加。自 90 纳米技术节点以来,电迁移一直是一个挑战,尤其是在更低节点如 28 纳米及以下。
电迁移现象:
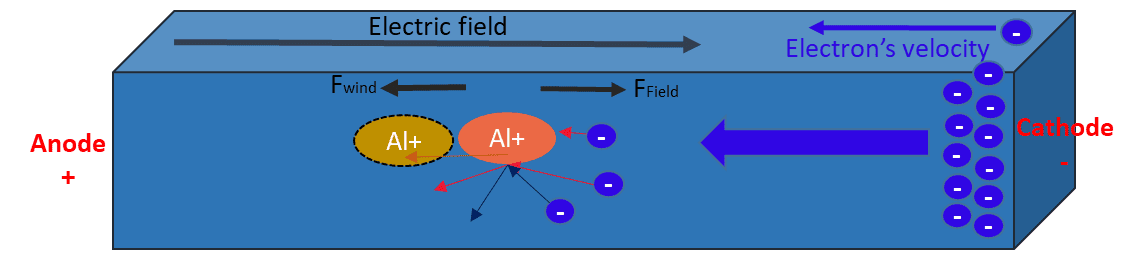
图1 电迁移现象
图1 展示了电迁移效应的现象:在金属互连之间施加电位差,形成从阳极到阴极的电场,导致电子朝着电场的反方向移动,从而产生电流。这些移动的电子具有动量,在与金属离子碰撞时,将使离子产生漂移现象。如果电流密度很高,电子风的力会超过电场力。
电迁移问题可能立即影响互连,也可能在运行几个月甚至几年后才显现,这取决于电流密度。因此,ASIC(Application-Specific Integrated Circuit,特定应用集成电路)的可靠性将受到电迁移效应的影响。
失效平均时间(MTTF)是评估集成电路寿命的一个关键指标,使用 Black 方程计算 MTTF,如下所示:

其中:
A = 横截面积
J = 电流密度
N = 缩放因子(通常设置为2)
Ea = 激活能
K = 玻尔兹曼常数
T = 开尔文温度
电迁移的影响:
一旦金属离子开始从原始位置移动,它们将在互连中造成问题。这可能导致离子在某个位置过多积累或者离子不足。因此,互连中可能出现膨胀或虚空。
另外,当电子流过金属线时,将同金属线的原子发生碰撞,碰撞导致金属的电阻增大,并且会发热。在一定时间内如果有大量的电子同金属原子发生碰撞,金属原子就会沿着电子的方向进行流动。这将会导致两个问题:第一,移动后的原子将在金属上留下一个空位,如果大量的原子被移动,则连线断开;第二,被移动的原子必须停在某一个地方,在电流方向的末端形成大量堆积。以铜导线为例,电流的趋肤效应导致电子都是在铜导线表面移动。当发生碰撞后,表面的原子不断被撞击的向导线末端移动。原子离开的地方铜线不断变细甚至断开,原子堆积的地方铜线不断变粗甚至有可能和周围铜线接触导致短路。

图2 互连中的膨胀和虚空形成
图2显示了膨胀和虚空的形成。
虚空:如果流入的离子通量小于流出的离子通量,则会在互连中创建一个虚空。虚空可能导致互连中的不连续,导致开路。
膨胀:如果流入的离子通量大于流出的离子通量,则会导致离子积聚并在互连中创建膨胀。膨胀可能增加金属互连的宽度并触及相邻的金属互连,可能导致短路。
电迁移的预防技术:
随着技术节点的缩小,使用的互连也在改变。最初,纯铝被用作互连,然后行业开始使用Al-Cu合金,后来转向铜互连。与铝互连相比,铜互连可以承受大约5倍的电流,同时保持类似的可靠性要求。
影响材料EM能力的因素有:导线长度、导线半径、电流密度、温度、通流时间。
导线长度越长,原子数量越多
导线半径越小,电子分布区域越小,电子越集中
电流密度越大,电子数量越多
温度越高,电子能量越大,原子越活跃
通流时间越长,碰撞发生的次数越多
在物理设计过程中,以下技术可用于预防电迁移问题。
- 增加金属宽度以降低电流密度
- 降低频率
- 降低供电电压
- 保持导线长度短
- 减少时钟线中的缓冲区大小
为了预防电迁移问题,物理签收阶段将执行电迁移检查,以符合晶圆厂提供的电迁移规则。
谢谢
[1] https://blog.csdn.net/m0_61623740/article/details/120162795
[2] https://teamvlsi.com/2020/08/electromigration-effect-in-vlsi.html

